Разделы
Полезные сайты
Счетчики
IBM "пронзила" чипы водяными капиллярами
Фото с сайта www.3dnews.ru
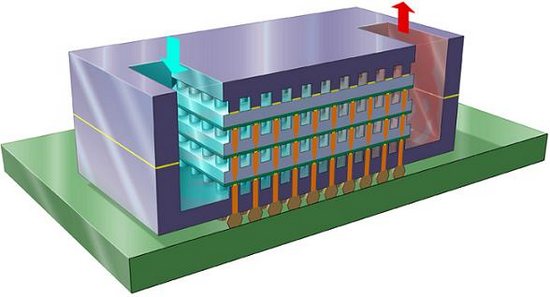 На днях исследователи компании IBM в сотрудничестве с институтом им. Фраунгофера (Берлин) продемонстрировали прототип, в котором каналы охлаждения интегрированы непосредственно в трехмерную микросхему, а вода пропускается между слоями этого чипа.
На днях исследователи компании IBM в сотрудничестве с институтом им. Фраунгофера (Берлин) продемонстрировали прототип, в котором каналы охлаждения интегрированы непосредственно в трехмерную микросхему, а вода пропускается между слоями этого чипа.
В прошлом году корпорация IBM предложила технологию производства «слоеных» чипов, позволяющую почти в 1000 раз сократить расстояние, которое необходимо преодолевать информации в микросхеме, а также позволяет реализовать в 100 раз больше каналов для обмена данными по сравнению с двухмерными чипами. Если в традиционном чипе компоненты размещаются на кремниевой подложке рядом друг с другом, то в трехмерном эти компоненты размещаются в несколько слоев.
Совокупное тепловыделение трехмерного чипа площадью 4 см2 и толщиной около 1 мм приближается к одному киловатту, что в 10 раз превышает тепловыделение электрической плитки. С целью эффективного отвода тепла от источника вода подается в расположенные между отдельными слоями чипа охлаждающие каналы, по толщине сравнимые с человеческим волосом (50 микронов).
При проведении экспериментов ученые пропускали воду через испытательный образец размером 1 х 1 см, который состоял из двух пластин (источников тепла) с размещенным между ними охлаждающим слоем. Этот слой имел размеры всего около 100 микронов в высоту и 10 тыс. вертикальных межсоединений на один см2.
Исследователи смогли обеспечить максимальный поток воды сквозь слои, сохранив при этом герметичную изоляцию межсоединений, препятствующую электрическим замыканиям вследствие воздействия воды. Созданную систему охлаждения ученые сравнивают с человеческим мозгом, в пространстве которого миллионы нейронов для передачи сигналов пересекаются с десятками тысяч кровеносных сосудов для охлаждения и энергоснабжения, не влияя друг на друга.
Создание отдельных слоев было достигнуто при использовании существующих методов производства, за исключением дополнительных операций, связанных с формированием отверстий для передачи сигналов между слоями. С целью изоляции этих «нервов» ученые оставили вокруг каждого межсоединения кремниевую оболочку (технология through-silicon vias) и добавили тонкий слой окиси кремния для защиты электрических межсоединений от воды. Такие структуры должны изготавливаться с точностью до 10 микронов, что в 10 раз превышает требования при изготовлении межсоединений и металлических элементов в современных чипах.
Для сборки отдельных слоев группа ученых разработала сложную технологию тонкопленочной пайки. С помощью этой технологии ученые достигли высоких показателей по качеству, точности и надежности, что гарантирует хороший тепловой контакт и отсутствие электрических замыканий. На завершающем этапе собранный чип был помещен в кремниевый охлаждающий контейнер, напоминающий миниатюрный бассейн. Вода закачивается в этот контейнер с одной стороны, протекает между отдельными слоями чипа и отводится с другой стороны контейнера.
С помощью моделирования ученые экстраполировали экспериментальные результаты на чип площадью 4 см2, при этом расчетная холодопроизводительность составила 180 Вт/см2.
В дальнейшем исследователи займутся оптимизацией систем охлаждения для чипов с уменьшенными размерами и с увеличенным числом межсоединений. Кроме того, группа будет исследовать возможность дальнейшего совершенствования структур для охлаждения отдельных горячих точек.
Информация с сайта www.3dnews.ru со ссылкой на www.ibm.com.
Автор оригинального текста: Александр Будик.